磷化铟具有高电子传输速度、低接触电阻和大异质结偏移等优势,被作为下一代高频高功率电子器件的新型半导体材料。随着电子设备的小型化和高功率运行需求渐涨,这些高功率密度设备的散热问题成了集成电路行业发展的绊脚石。金刚石具有固体材料中最高的热导率 (2200 W/m/K),以金刚石作为散热衬底与器件直接键合是减小热阻的理想选择。而目前关于 InP 和金刚石衬底直接键合的研究很少。
来自日本国家先进工业科学技术研究所的Takashi Matsumae团队通过将氧等离子体活化的 InP 基板和用NH3/H2O2清洁的金刚石衬底在大气条件下接触,随后将InP/金刚石复合样品在 250°C 下退火,使两种材料通过厚度为 3 nm 的非晶中间层形成了剪切强度为 9.3 MPa 的原子键。相关论文以题为“Low‑temperature direct bonding of InP and diamond substrates under atmospheric conditions”发表在Scientific Reports。
论文链接:
https://www.nature.com/articles/s41598-021-90634-4

该研究团队通过大量金刚石与其他半导体材料衬底(如硅、氧化镓等)直接键合研究发现,在用如H2SO4/H2O2和NH3/H2O2混合物氧化溶液处理过的金刚石表面可形成 OH 基团。此外,OH封端的金刚石表面可通过大约 200 °C 下热脱水与OH封端的半导体衬底形成直接键合。虽然对 InP 和金刚石键合的研究很少,但光电子科学家已经实现了氧等离子体激活的 InP 激光器和 Si 波导的直接键合。为此,该研究团队提出了 InP 和金刚石基板的直接键合工艺方案,并研究了 InP/金刚石键合界面的纳米结构,如图 1 所示。

图1
图2为结合在 InP 衬底表面的金刚石基板,可以通过透明的金刚石基板观察到两者的键合界面。同时可以观察到两层基板之间的间隙引起的漫反射,如果环境清洁度和基板表面平整度得到改善,则大部分接触区域将形成直接键合。对结合的金刚石基底上施加 9.3 MPa(84 N for 3 × 3 mm)的剪切力时,结合界面处产生断裂,通时沿 InP(110)面发生解理。该团队之前的研究中,Si/金刚石和Ga2O3/金刚石的剪切强度分别为 31.8 和 14 MPa。虽然InP/金刚石的键合界面较低,但已满足 MIL STD 883E 的芯片剪切强度要求。

图2
衬底表面需要足够光滑才能形成直接粘合,其均方根(RMS)粗糙度最好小于~ 5 Å。表面需要足够光滑才能直接粘合;本研究中使用的金刚石基材具有原子级光滑的表面,RMS 粗糙度小于 3 Å;InP 衬底表面的 RMS 粗糙度最初为 2.76 ± 0.3 Å,而氧等离子体刻蚀后的表面粗糙度为3.03 ± 0.3 Å;对于形成键合来说足够光滑,图3为原子力显微镜AFM下的InP表面形貌。
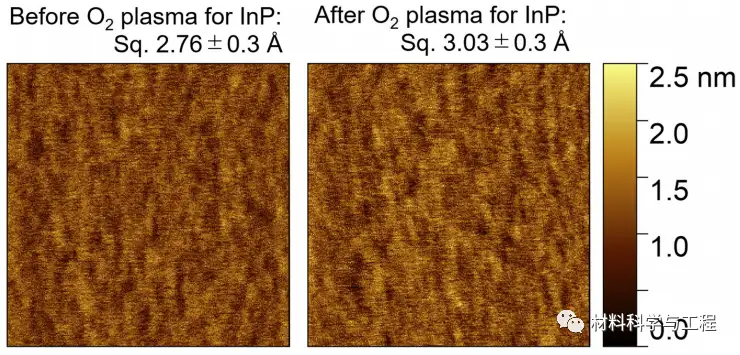
图3
通过角分辨 X 射线光电子能谱 (XPS) 研究了InP衬底的表面化学成分,如图 4 所示。测量深度取决于光电子的(take-offangle),掠出角为10.75° 和 63.25°时,非弹性平均自由程 (IMFP) 的计算值分别大约1和4nm。

图4
在等离子体刻蚀之前,In-O 和 P-O 键的数量相对较少,并且衬底表面存在有机污染物。这表明表面检测到的 OH 基团可能是由污染物中的 C-OH 键引起的。而在等离子体处理后,有机污染物已被刻蚀殆尽,而InP 表面依然存在In-O 和 P-O键。因此,在表面检测到的 OH 键可能归因于InP 衬底上产生的 In-OH、P-OH,表明InP 和金刚石衬底上的 OH 基团可能在键合过程中相互反应。
使用聚焦离子束 (FIB) 将InP样品减薄至10μm后,使用透射电子显微镜 (TEM) 观察 InP/金刚石结合界面的纳米结构,如如图 5 所示。可在InP和金刚石基板接合界面处观察到厚度约为 3 nm 的非晶层,而且两者之间没有形成裂纹或纳米空隙的原子键。

图5
使用能量色散X射线光谱 (EDX) 进行成分分析,如图6所示。键合界面的非晶层由In、P、O和C组成,为典型的通过氧等离子体处理后的结果;而C原子据推测扩散到由氧等离子体形成的InP衬底上的氧化物层中。虽然中间过渡层的热导率较低,但与传统方法(例如 2–4 µm 厚的金属层)相比非常薄。因此, InP/金刚石键合技术将有助于InP电子器件的有效散热。

图6
总的来说,本文提供了一种将InP和金刚石衬底直接键合的工艺,以改善InP基电子设备的散热情况。该工艺通过由氧等离子体处理的InP衬底与在大气条件下用NH3、H2O2和H2O的混合物清洗过的金刚石衬底接触,然后在250 °C下对接触的样品进行退火来形成直接键合。由于在预键合处理后两个基底表面都是原子级光滑的,因此InP和金刚石基板成功地产生了剪切强度为 9.3 MPa 的直接键合。界面分析表明,它们通过厚度约为3 nm的非晶中间层结合,没有裂纹或纳米空隙。由于可以通过简单的程序实现先进的热管理,因此这种键合技术将有助于未来具有更高集成度和功率密度的InP半导体电子器件。
但作为一个以热管理为目的的键合工艺,笔者认为,InP/金刚石复合材料的热导率测量与散热效率类比应该是必不可少的。但文中提供的键合方式,相比当前制备氮化镓/金刚石、硅/金刚石等复合材料的异质外延化学气相沉积(CVD)、磁控溅射等工艺简单高效了不少,并降低了生产成本,有助于新型集成半导体电子材料的快速量产。
本文来自微信公众号【材料科学与工程】,未经许可谢绝二次转载至其他网站,如需转载请联系微信公众号mse_material
本文版权归原作者所有,文章内容不代表平台观点或立场。如有关于文章内容、版权或其他问题请与我方联系,我方将在核实情况后对相关内容做删除或保留处理!